プリント基板総合メーカー|RITAエレクトロニクス株式会社 > 技術資料 > 半導体パッケージとプリント基板の接続信頼性

- クロストークの現象とは
~クロストークの原理と対策 - 信号のリターンパス不連続から
発生するノイズとその対策 - DDR3メモリバスの設計手法
~特徴からトポロジー種類を詳細解説 - 高多層基板、ビルドアップ基板製造
- プリント基板のノイズ対策
~電源・グラウンド対向部位
でのポイント - DCバイアス時のコンデンサの容量低下と電源供給線への影響
- 放射ノイズ抑制においてプレーン共振解析を活用した低ノイズ設計
- スルーホールのインピーダンス制御設計手法の開発
- パターン設計時に使用部品の生産中止(EOL)情報を入手し、開発時および将来の部品調達リスクを低減(本サービスは終了致しました。)
- 信号伝送速度とプリント基板材質に応じた最大配線長の目安
半導体パッケージとプリント基板の接続信頼性
- 1.まえがき
温度変化の著しい環境下でプリント基板の実装品(ボード)が使用される場合、温度変化の繰り返しにともない、プリント基板内部や、プリント基板と半導体または電子部品との界面にクラック(ひび)が生じ、導通不良(オープン)となる可能性がある。
ボードの信頼性向上には、プリント基板の材質や設計仕様など、様々な選択肢があり、半導体パッケージ構造も、大きな影響を及ぼすことが予想される。
今回、半導体パッケージ構造とプリント基板との接続信頼性に関する検証を行ったので、その結果を報告する。
- 2.評価
2.1 評価内容
評価サンプルに対し、温度サイクル試験を1000サイクルまで行い、各部品のGND端子間を導通抵抗値を測定した。評価サンプルに関しては2.2、試験条件に関しては2.3に示す。
2.2 評価サンプル
部品接続信頼性の評価サンプル(図1)は、下記(1)~(3)の組み合わせを試した。
(1)搭載する半導体パッケージ構造(3種類)
(i)BGA
(ii)QFP
(iii)QFN(2)基板材質(3種類。カッコ内の表記順はコア材/プリプレグ)
(i)一般FR-4材(日立化成 MCL-E-67/GEA-67N)
(ii)ハロゲンフリー材(パナソニック R-1566/R-1551)
(iii)低熱膨張材(日立化成 MCL-E-700G(W)/GEA-700G)(3)基板設計仕様(2種類)
(i)BGA実装品:BGAパッドへソルダレジスト被覆の有無
(ii)QFP, QFN実装品:デバイス中央と基板との半田接続の有無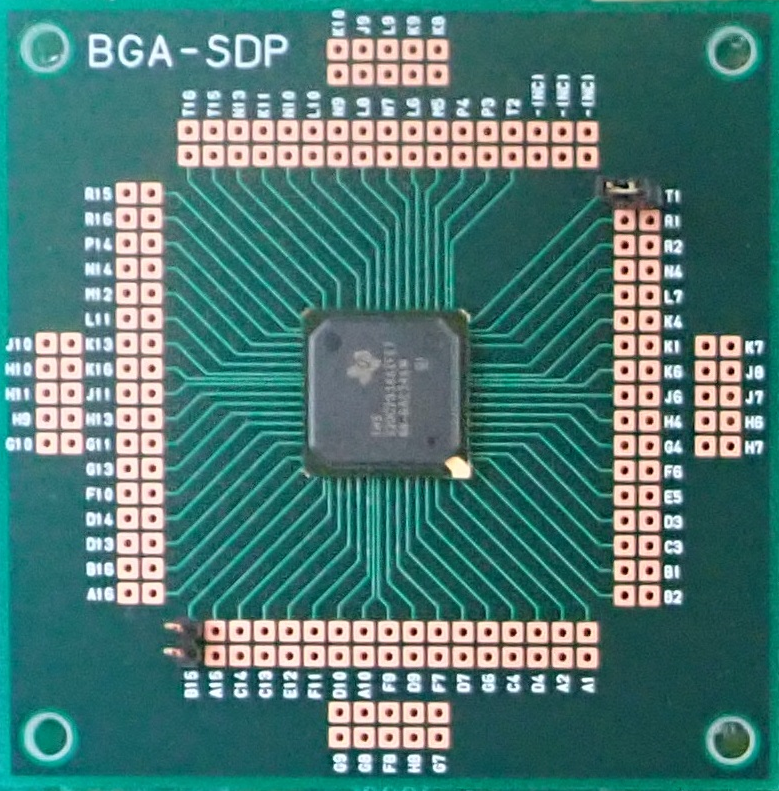
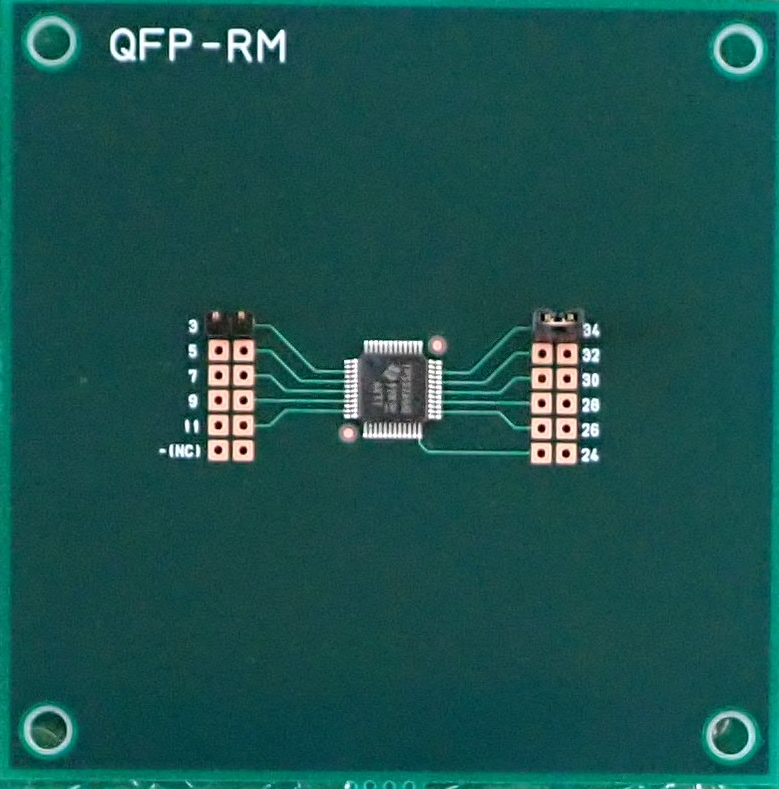
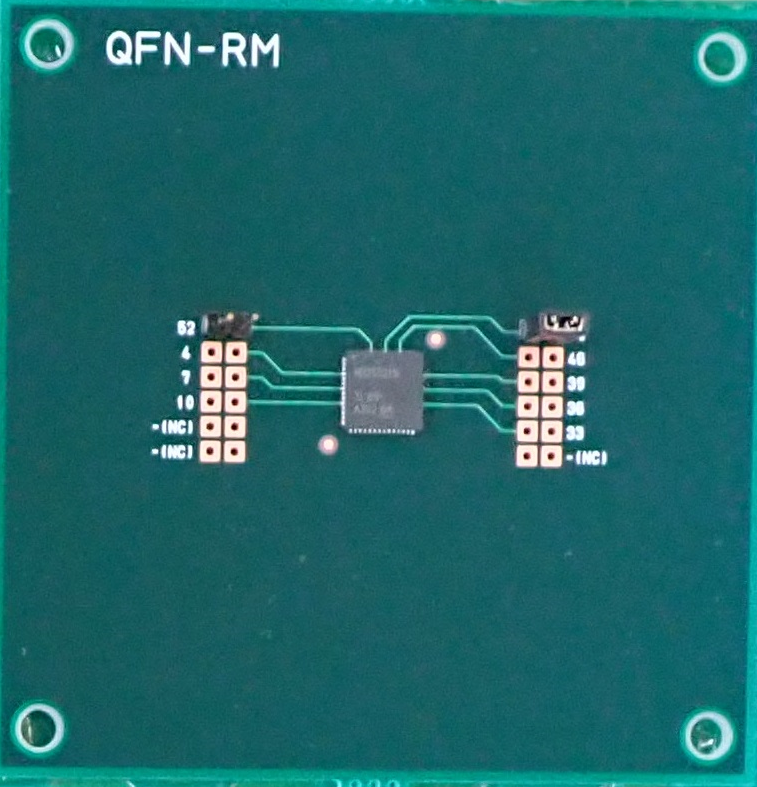
(i)BGA搭載基板 (ii)QFP搭載基板 (iii)QFN搭載基板 図1 評価サンプル 2.3 試験条件
(1)温度サイクル:-40℃/30分⇔室温/5分⇔80℃/30分(各移行時間は1分程度)
室温からスタートし、-40℃に冷却。室温に戻し、+80℃に加熱。室温に戻して1サイクルとした。(2)抵抗値測定:100サイクル毎に室温にて導通抵抗値を測定した。
- 3.結果
BGA搭載基板、QFP搭載基板、QFN搭載基板、すべての評価サンプルに対し、1000サイクルまでの導体抵抗値変化率は±5%以下で接続不良は生じなかった。
導体抵抗値変化率の評価結果の例を図2に示す。
図2 BGA搭載基板、BGAパッドにレジスト被膜ありの評価結果
- 4.まとめ
BGA、QFP、およびQFNパッケージの半導体を3種類の材質のプリント基板(一般FR-4、ハロゲンフリーFR-4、および、低熱膨張率材)に実装し、-40℃/+80℃の温度サイクルを行った結果、1000サイクル経過後、すべての基板材料、半導体パッケージにて、接続不良は生じなかった。
無料ダウンロード!

【ダウンロード資料例】
- DDR3メモリバスの設計手法
- 差動伝送路の設計と信号品質
- 12G-SDIリターンロス規格合致のための基板設計手法
- IBIS-AMIモデルを用いた高速信号シミュレーション
- 10Gbps超伝送の基板設計最適化
など全70テーマ
この機会に是非ご登録ください。 ※会員登録は無料です。



























