プリント基板総合メーカー|RITAエレクトロニクス株式会社 > 技術資料 > 高多層基板、ビルドアップ基板製造

高多層基板、ビルドアップ基板製造
モバイル機器の小型化、薄型化、および、通信機器の高機能化により、狭ピッチ、多ピンパッケージをを高密度実装する要求が高まってきています。それに伴いプリント基板も高多層化および高密度化が進んでいます。
- 1. 高多層基板、多重積層(IVH、BVH)基板
高多層基板としては30層まで量産対応しています(図1)。仕様を表1に示します。特殊加工として、特性インピーダンスコントロール、穴埋め、 電解めっきリード除去、端面スルーホール、座ぐり加工、皿もみ加工、バックドリル、部品内蔵が可能です。

図1. 高多層(30層、板厚4.0mm)基板

高密度化対応として最も有効な手段としては、ビアを小径にする方法があります。しかし、φ0.1㎜以下のスルーホールを加工するなかで、加工条件は、穴品質に直結、大きな影響を与えるため、充分な加工技術の検討が必要不可欠です。
主な穴品質は、穴位置精度・穴内壁面粗さ・CAFなどがあり、プリント配線板おける機能トラブルを引き起こす危険性があります。穴品質に影響を与える要因として、設備・環境・作業方法等がありますが、中でも副資材や加工条件が占めるウエイトが最も高くなります。弊社では、穴内位置・穴内品質を重視で検討し、最適な副資材(E/S、B/B等)を使用しています。さらに、良質なスルーホールを形成する上で、めっき技術も重要な要因の一つであり、定期的試験に加え、めっき特性(伸び率、抗張力)も定期確認を行い、安定しためっき特性を維持、管理しています。
- 2. ビルドアップ基板
多層基板には信頼性の利点がありますが、全層を貫通するスルホールをあけ、内部にめっきを施し各層の接続をするこの方式には「ドリル加工によるためため小径化の限界がある」、「スルホール貫通しているため配線の自由度が低い」という問題があり、これを克服したのがビルドアップ基板となります。
標準設計仕様を図3に、3段ビルドアップの断面写真を図4に示します。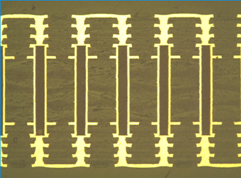
図4. 3段ビルドアップ基板
信頼性を十分に確保するため、材料としてはTgが高い材料を使用しています。また、レーザビアの接続信頼性を確保するため、材料には扁平開繊クロス材を使用すると共に、レーザ加工条件を最適化しています。狭ピッチ対策としては、レーザビア直下層を基準としたアライメント方式とダイレクトイメージャーによる高位置精度回路形成方法を採用しています。
無料ダウンロード!

【ダウンロード資料例】
- DDR3メモリバスの設計手法
- 差動伝送路の設計と信号品質
- 12G-SDIリターンロス規格合致のための基板設計手法
- IBIS-AMIモデルを用いた高速信号シミュレーション
- 10Gbps超伝送の基板設計最適化
など全70テーマ
この機会に是非ご登録ください。 ※会員登録は無料です。