プリント基板総合メーカー|RITAエレクトロニクス株式会社 > 技術資料 > 温度変化環境下における半導体~プリント基板間の半田接合部位の接続信頼性

- クロストークの現象とは
~クロストークの原理と対策 - 信号のリターンパス不連続から
発生するノイズとその対策 - パターン設計時に使用部品の生産中止(EOL)情報を入手し、開発時および将来の部品調達リスクを低減(本サービスは終了致しました。)
- DCバイアス時のコンデンサの容量低下と電源供給線への影響
- GaNデバイス搭載プリント基板のパターン設計最適化検討
- 56Gbps PAM4高速伝送の実機検証
- プリント基板のノイズ対策
~電源・グラウンド対向部位
でのポイント - 信号伝送速度とプリント基板材質に応じた最大配線長の目安
- EMI抑制ルールチェッカーを活用した低ノイズ設計
- 温度変化環境下における半導体~プリント基板間の半田接合部位の接続信頼性
温度変化環境下における半導体~プリント基板間の半田接合部位の接続信頼性
- 1.背景
(1)概要
温度変化の著しい環境下でプリント基板の実装品(ボード)が使用される場合、温度変化の繰り返しにともない、プリント基板内部や、プリント基板と半導体または電子部品との界面にクラック(ひび)が生じ、導通不良(オープン)となる可能性があります。
ボードの信頼性向上には、プリント基板の材質や設計仕様など、様々な選択肢があります。半導体パッケージの構造も大きな影響を及ぼすことが予想されます。
しかし、従来は実験結果が無く、信頼性が分かりませんでした。
(2)半導体パッケージの影響
プリント基板にBGAパッケージの半導体を実装した際、接続部位である半田ボールは柔軟性が低いため、温度変化にともなうプリント基板の寸法変化に対する追従性がリードを有するQFPよりも劣ることが危惧されます。
(3)プリント基板の材質の影響
プリント基板の材質としては、一般FR-4よりもハロゲンフリーFR-4や低熱膨張率材の方が温度変化にともなう寸法変化が小さいため、半導体~プリント基板間の接続部位にかかるストレスは小さく、この部位の信頼性が向上することが期待されます。
- 2.方法
(1)テストボードの仕様
今回、半導体パッケージとしてBGAのほか、比較用にQFPとQFNを加えた3種類を用い、プリント基板の材質としては一般FR-4、ハロゲンフリーFR-4、低熱膨張率材の3種類として、これら9種類の実装品を作成しました(図1)。
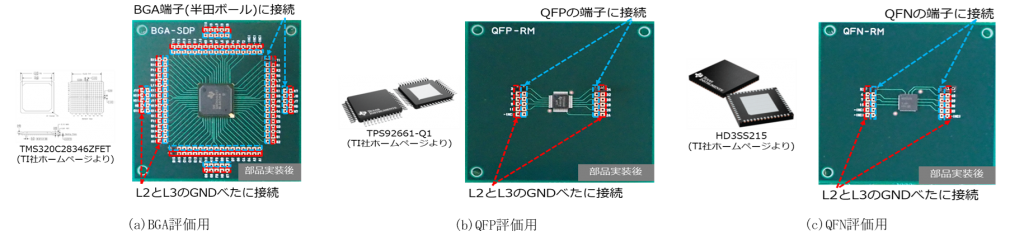
図1 半導体~プリント基板間の接続信頼性テストボード
(2)温度サイクル試験
これらについて温度サイクル試験を行い、半導体~プリント基板間の接続部位の信頼性に及ぼす半導体パッケージ構造やプリント基板材質の影響を検討しました。
ここで、BGA実装品についてはBGAパッドへのソルダレジスト被覆の有無、QFP・ QFN実装品についてはデバイス中央と基板との半田接続の有無の影響についても調査しました。
故障有無の判定は導通抵抗値測定にて行いました(図2)。
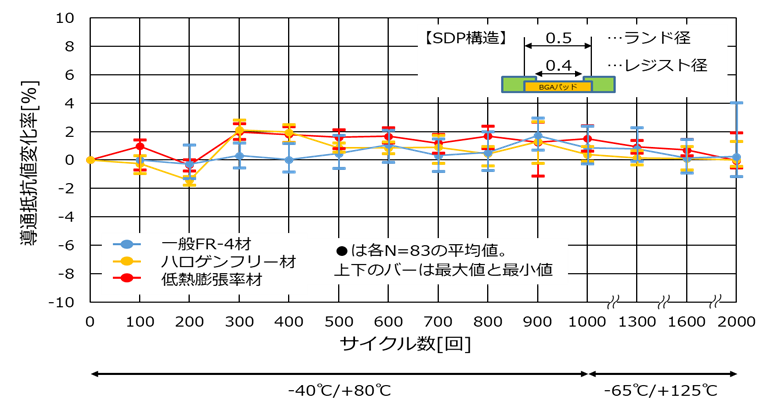
図2 温度サイクル試験結果
(BGA半導体(BGAパッドへのレジスト被覆有)・一般FR-4材基板の場合)
一部のサンプルについては断面観察を行いました(図3)。
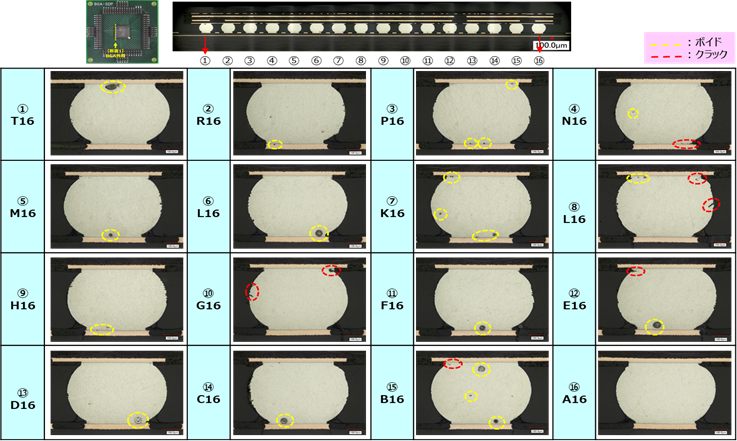
図3 温度サイクル後の断面観察結果
(BGA半導体・一般FR-4材基板の場合)
(3)実環境における寿命の推定
今回の-65℃/+125℃等の加速試験条が、実際の市場環境(0℃/+85℃等)では何年に相当するか求め、寿命を推定しました。
- 3.結果
加速試験として-40/80℃や-65℃/125℃の温度変化を加えたとき、ほとんどの場合で故障しませんでした。この加速試験を市場環境として0/80℃に換算すると約9年に相当します。したがって、今回試験した半導体パッケージ種類やプリント基板材質のすべての組み合わせにおいて、高い信頼性があることを確認できました。
資料全文は当社会員ページ・特別会員用となっております。登録・申請をお願い致します。
無料ダウンロード!

【ダウンロード資料例】
- DDR3メモリバスの設計手法
- 差動伝送路の設計と信号品質
- 12G-SDIリターンロス規格合致のための基板設計手法
- IBIS-AMIモデルを用いた高速信号シミュレーション
- 10Gbps超伝送の基板設計最適化
など全70テーマ
この機会に是非ご登録ください。 ※会員登録は無料です。



























